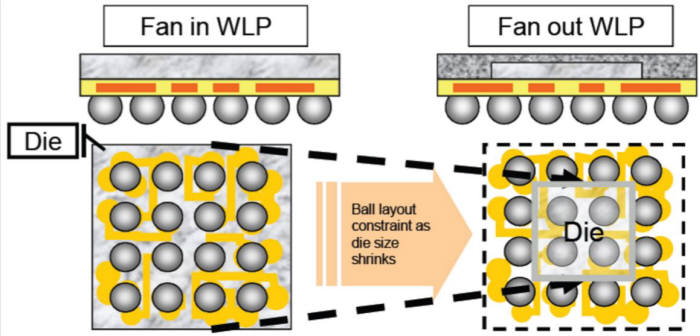
차세대 반도체 패키지 기술 시장을 선점하기 위해 주요 업체가 바삐 움직이고 있다.
27일 업계에 따르면 삼성, TSMC, 앰코, ASE는 팬아웃웨이퍼레벨패키지(FoWLP:Fan Out Wafer Level Package) 양산 라인을 구축하거나 기술 확보에 매진하고 있다.
팬아웃은 입출력(I/O) 단자 배선을 바깥으로 빼 I/O를 늘리는 기술이다. 이 기술을 활용하면 I/O가 많은 고성능 칩도 저렴한 원가로 웨이퍼레벨 패키징이 가능하다. 반도체 패키지용 인쇄회로기판(PCB)이 필요 없어 추가적인 원가절감이 크다. 패키지 면적도 축소된다.
대만 TSMC는 독자 InFO(Intgrated Fan Out) 기술로 FoWLP 시장에 대응한다. 이미 양산 라인을 구축 중이다. 차세대 애플 아이폰용 애플리케이션프로세서(AP)에 InFO 패키지 기술이 적용될 것으로 업계에선 보고 있다.
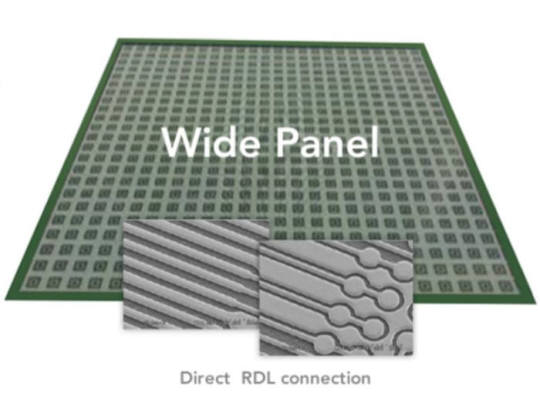
삼성전자는 삼성전기와 함께 내년 초 FoPLP(Fan Out Panel Level Package) 기술을 상용화할 계획이다. 삼성전자는 기술을 제공하고 실제 패키지 사업은 삼성전기가 맡을 전망이다. 삼성전기는 천안 삼성디스플레이 노후 액정표시장치(LCD) 생산 라인 일부를 이관 받아 패키지 공장으로 전환 중이다. 삼성은 AP와 쌍으로 붙는 자체 전력관리IC(PMIC)에 이 기술을 적용한다. 웨이퍼처럼 동그란 기판이 아닌, 네모난 기판 패널 위에서 패키지 작업을 하는 기술이어서 원가 경쟁력이 높다고 삼성전자는 강조했다.
외주 반도체 패키지 테스트(OSAT:Outsourced Semiconductor Assembly and Test) 업계도 적극적으로 이 기술에 대응한다.
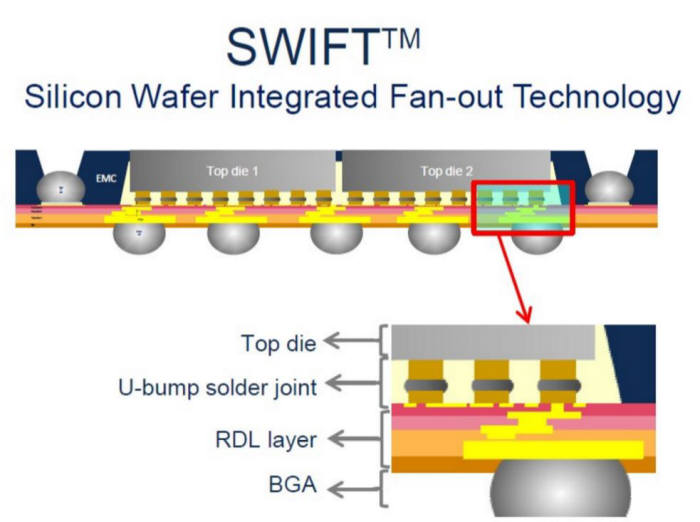
앰코테크놀로지는 인천 송도에 건설 중인 신규 패키지 공장 `K5`에서 FoWLP 양산에 나선다. 앰코 기술명은 스위프트(SWIFT:Silicon Wafer Integrated Fan out Technology)다. 앰코는 K5공장 가동 시기를 조율 중이다. 지난해 연말 일본 패키지 업체 J-디바이스를 인수한 앰코는 삼성과 마찬가지로 FoPLP 기술도 확보한 것으로 전해졌다.
대만 ASE는 FoWLP 기술을 보유한 미국 패키징 업체 데카테크놀로지에 최근 6000만달러 투자를 단행했다. 데카가 보유한 기술로 FoWLP 시장에 대응하겠다는 것이 ASE의 전략이다. 중국 JCET에 인수된 스태츠칩팩 역시 해당 기술을 개발 중인 것으로 알려졌다.
업계 관계자는 “삼성은 독자 패키지 공장을 이미 운용하고 있었으나 TSMC는 FoWLP 기술을 시작으로 전후공정 턴키 솔루션을 제공하겠다는 계획을 세웠다”며 “TSMC의 패키지 시장 진입으로 OSAT 업계는 일감이 줄어들까 우려하고 있다”고 분위기를 전했다.
한국 OSAT인 네패스는 이미 FoWLP 기술 상용화에 성공했다. NXP반도체의 77GHz 중장거리 차량 레이더 센서는 네패스의 FoWLP 기술이 접목된 제품이다. 올해부터 관련 물량이 늘어날 것으로 회사는 내다봤다.
업계에선 향후 AP와 D램 등 다양한 칩을 함께 패키징하는 2세대 FoWLP 기술이 상용화될 것으로 전망하고 있다.
한주엽 반도체 전문기자 powerusr@etnews.com








