
SFA반도체가 올해 웨이퍼 범핑 생산능력을 갑절로 늘린다. 현재 월 웨이퍼 8000장인 생산능력을 1분기 1만장, 연말 1만5000장으로 확대한다. 2015년 시작한 범핑 사업이 올해 본격화될 것으로 예상된다.
11일 업계에 따르면 SFA반도체는 1분기에 월 8000장인 웨이퍼 범핑 생산능력(8인치, 12인치 합산)을 1만장으로 증설한다. 올해 말 1만5000장까지 늘릴 계획이다. 웨이퍼 범핑부터 플립칩(FC), 웨이퍼레벨 칩스케일패키지(WLCSP) 등으로 이어지는 턴키 비즈니스 모델 강화로 풀이된다.
SFA반도체는 2015년 하반기 웨이퍼 범핑 사업을 시작했다. 지난해 3분기 누적 웨이퍼 범핑 매출은 101억원이다. 3분기 분기매출 44억원을 기록한 것을 감안하면 지난해 연간매출은 140억원 이상으로 추정된다.

SFA반도체 관계자는 “지난해 웨이퍼 범핑은 턴키가 아닌 단일 비즈니스로 대응했다”면서 “턴키 방식은 샘플 테스트 중”이라고 말했다. 웨이퍼 범핑은 후공정의 전공정에 비유되는 기술 집약 패키지 과정 중 하나다. SFA반도체 범핑 방식은 솔더볼로 범핑을 만드는 이른바 `볼범핑`이다.
올해 증설 계획인 1만5000장의 연매출 환산 규모는 430억원이다. 반도체 패키지업계 관계자는 “웨이퍼 범핑사업 손익분기점은 1만장 수준”이라면서 “국내 웨이퍼 범핑은 공급보다 수요가 큰 상황”이라고 말했다.
국내 메모리 주력 반도체 패키지·검사 외주(OSAT) 업체 3곳 가운데 SFA반도체가 가장 먼저 범핑 웨이퍼 사업을 본격화했다. SFA반도체, 하나마이크론, 시그네틱스는 그동안 네패스 등에서 범핑한 웨이퍼를 받아 패키지를 해왔다. 시그네틱스는 웨이퍼범핑 8인치 설비를 깔았지만 양산매출은 아직 발생하지 않고 있다.
웨이퍼 범핑은 전공정을 끝낸 팹아웃(fab out) 웨이퍼에 노광, 증착(도금) 등 공정을 거친다. 칩(Die) 입·출력(I/O) 전극 위로 UBM(Under Bump Metallurgy)을 올리고 그 위에 솔더볼, 솔더페이스트, 구리 필러(기둥) 등 범프 소재를 쌓는다. 금속층인 UBM은 접착제 역할이다.
웨이퍼 범핑은 와이어본딩을 대체한다. 플립칩, 웨이퍼레벨 칩스케일패키지 등에서 칩과 PCB(메인기판 아님)를 연결한다. 칩 표면을 모두 I/O 단자로 활용, I/O개수를 늘리고 전송속도를 빠르게 한다. 다수 I/O와 빠른 전송속도가 필요한 비메모리 패키지에 주로 사용된다.
SFA반도체는 지난달 필리핀 법인 생산시설 2단지 공사를 착공했다. 1차 공사 투자금액은 약 900억원(7500만달러)으로 오는 10월 양산 일정이다. SFA반도체 관계자는 “생산 계획은 아직 확정되지 않았다”면서 “신규 고객을 확보해 제품을 다양화할 것”이라고 했다.
국내 생산라인과 필리핀 법인(PSPC)은 각각 모바일용 메모리, PC·서버용 메모리가 주력이다. 웨이퍼범핑은 국내에서 모바일 비메모리 패키지용으로 대응하고 있다.
비메모리 패키지가 주력인 중국 법인(PSTS)은 지난해 3분기에 흑자 전환(분기)했다. SFA로 인수되기 전인 2015년 상반기 740명이던 인력을 2016년 3분기 391명으로 50% 가까이 줄였다.
〃SFA반도체 웨이퍼 범핑 사업 추이
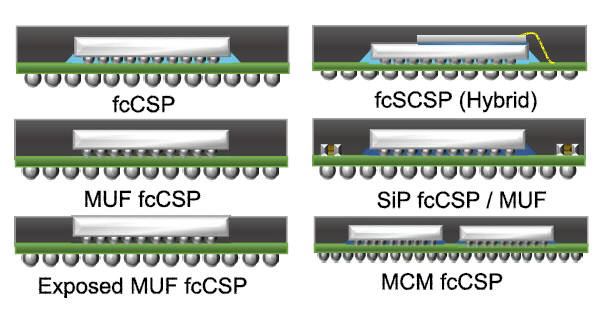
이종준기자 1964winter@etnews.com









