독일 레이저장비 업체 LPKF가 반도체 관통전극용 유리 인터포저(회로 기판과 칩 사이에 들어가는 기능성 패키지판) 가공 장비를 개발했다. 실리콘관통전극(TSV) 인터포저 대체 소재 중 하나로 유리가 꼽히는 가운데 전용 가공장비 개발이 관련 소재 변화를 이끌지 주목된다.
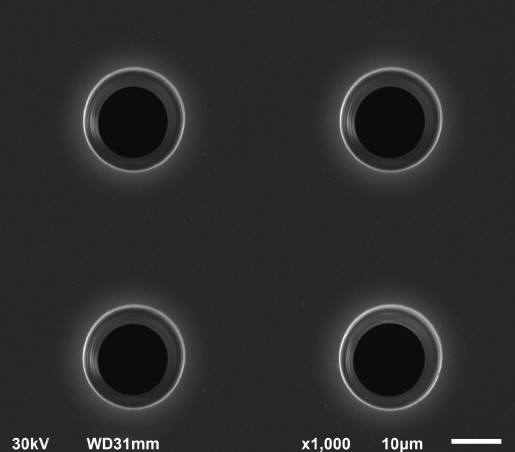
LPKF코리아(한국지사장 피터 비르크너)는 독일 본사에서 최근 유리관통전극(TGV:Through Glass Via) 인터포저 가공 장비를 개발했다고 5일 밝혔다. 시제품 성능 테스트를 거쳐 연내 국내 시장에 선보인다.
TSV 인터포저는 칩과 기판 등을 수직으로 관통하는 전극을 형성해 전기적 신호를 연결하는 시스템인패키징(SiP)에 사용된다. SK하이닉스도 올해 초 TSV 양산라인을 본격 가동하는 등 차세대 기술로 각광받고 있다.
유리는 기존 TSV 인터포저보다 가격과 성능 경쟁력이 우수해 대체 소재 중 하나로 꼽힌다. 적은 신호 손실률과 전력 소모에 강점이 있다는 평가다. 한국코닝도 유리 소재 캐리어 웨이퍼와 함께 유리 인터포저를 선보여 이목을 끌었다.
LPKF가 개발한 장비는 자체 레이저 컷팅 기술로 인터포저용 유리를 가공해 TGV 솔루션을 제공한다. 유리 강도를 유지하면서 매끄러운 표면을 가진 고품질 관통전극 제조에 유리하다는 것이다.
한번의 레이저 펄스로 비아홀 한 개를 뚫을 수 있고 초당 5000개 이상 TGV 형성이 가능해 원가 절감과 수율 향상에 기여할 것으로 전망된다. 지난해 개소한 한국지사를 중심으로 국내 반도체 업체와 협력해 솔루션 최적화에 나설 예정이다.
노재헌 LPKF코리아 상무는 “기존 실리콘 인터포저에 비해 유리 인터포저의 성능과 가격이 유리하지만 그동안 전용 장비와 가공 기술이 확보되지 않아 대안으로 채택되기 어려웠다”며 “조만간 주요 업체 관계자들을 초청해 기술을 시연하고 협력 방안을 논의할 것”이라고 말했다.
패키징 소재별 대표적 특징 비교
(자료:조지아공과대학)
박정은기자 jepark@etnews.com









