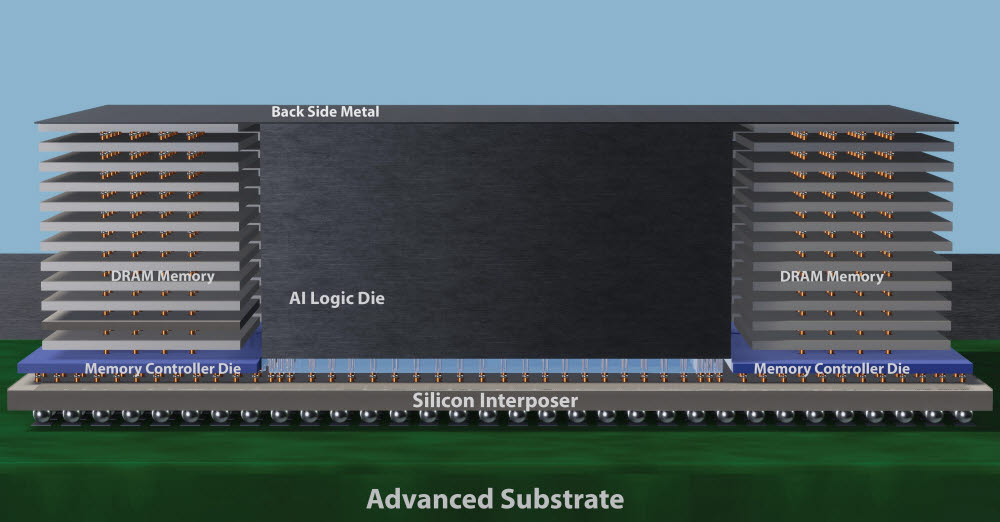
어플라이드 머티어리얼즈는 16일 다양한 기능과 크기의 반도체를 하나의 패키지로 제작할 수 있는 신기술을 발표했다. 어플라이드 머티어리얼즈는 해당 기술로 반도체 전력·성능·크기·비용·출시소요기간(PPACt)를 개선할 것으로 기대했다.
어플라이드가 발표한 기술은 △다이 투 웨이퍼(die-to-wafer) 하이브리드 본딩 △웨이퍼 투 웨이퍼 본딩 △첨단 기판 기술이다. 다양한 기술과 기능을 구현한 여러 크기의 반도체를 하나의 패키지에 담는 '이종 결합'을 위한 첨단 패키징 기술이다.
다이 투 웨이퍼 하이브리드 본딩은 구리와 구리의 직접 연결해 입출력(I/O) 성능을 높이고 배선 길이를 줄일 수 있다. 이를 적용하면 반도체 성능과 전력, 공정 비용 개선이 기대된다. 웨이퍼 투 웨이퍼 본딩은 서로 다른 두 웨이퍼를 접합해 보다 뛰어난 소자를 생성하는 기술이다. 첫 번째 웨이퍼에는 반도체 구조를, 두 번째 웨이퍼에는 다른 요소를 구현한 다음 두 웨이퍼를 결합하는 방식이다.
첨단 기판 기술은 패널 레벨 가공 기술이다. 가로·세로 500㎜ 이상 대형 기판에서 패키징하는 방식으로 웨이퍼에서 패키징하는 것보다 공정 효율성을 높일 수 있다.
니르말리야 마티 어플라이드 머티어리얼즈 첨단패키징부문 부사장은 “업계를 선도하는 어플라이드의 첨단 패키징 포트폴리오는 고객에 이종 결합 기술 구현에 필요한 폭넓은 옵션을 제공한다”면서 “우리는 기술 공동 최적화와 다른 기업과 협업으로 고객 PPACt 로드맵을 가속화하고 새로운 성장 기회를 만드는 생태계를 조성하고 있다”고 밝혔다.
권동준기자 djkwon@etnews.com









