
국내 반도체 생태계 최대 약점으로 지목됐던 첨단 패키징 기술 확보 프로젝트가 시작된다. 인공지능(AI)과 같은 차세대 반도체를 구현할 '2.5D와 3D 패키징', 미래 반도체 기판으로 주목받는 '유리기판'이 타깃이다.
과학기술정보통신부는 최근 2028년까지 총 553억원을 투입하는 반도체 패키징 사업을 개시했다. 공고를 내고 총 12개 과제를 다음달부터 시작한다고 밝혔다.
△2.5D·3D 적층 패키징 △유기기판 소재·공정 △하이드브리드 본딩 △첨단 패키징용 인터포저 소재·공정 기술 개발이 핵심이다.
2.5D·3D 패키징은 중앙에 연산을 담당하는 로직 반도체를 두고 주변에 고대역폭메모리(HBM) 등을 배치·상호 연결하는데 필수인 기술로, 최근 급부상한 AI 반도체를 겨냥했다. TSMC가 엔비디아 등 AI 반도체 고객을 다수 확보하게 한 일등공신이다.
유리기판은 기존 플라스틱 기반 기판의 한계 극복을 위해 나온 신기술이다. AI 등 고성능 반도체 구현을 위해 떠올라 세계 최대 반도체 업체인 인텔이 도입을 적극 추진 중이다.
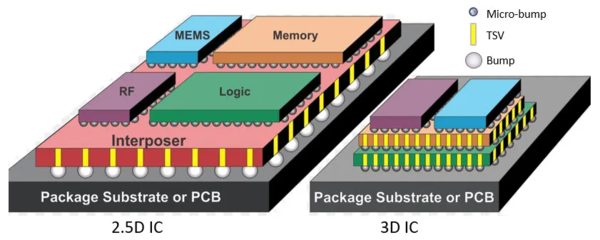
이 외 하이브리드 본딩은 D램과 낸드 등 메모리 분야에서 떠오르는 차세대 패키징 기술이며, 인터포저는 반도체(다이)를 연결하는 핵심 소재다. 양 기술 모두 외산 의존도가 높고, 국내 경쟁력은 해외에 뒤처진 것으로 평가된다.
업계에서는 이번 과제가 취약했던 반도체 패키징 경쟁력을 끌어올릴 기회로 보고 있다. 삼성전자와 SK하이닉스와 같은 일부 대기업을 제외하면 첨단 패키징 대응 역량이 부족하기 때문이다. 대만·일본 대비 열악한 산업 생태계를 개선하려면 국가 주도 R&D가 필수라는 지적이 이어왔다.
한 반도체 후공정 업계 관계자는 “국내 반도체 생태계는 지금까지 메모리 중심으로 기술을 갖춰와 첨단 패키징 한계가 분명했다”며 “(이번 R&D 사업이) 첨단 패키징 기술 생태계를 강화하는 마중물이 되길 기대한다”고 밝혔다.
분위기를 반영하듯 R&D 사업 사전 수요조사에서 다수 소재부품장비 기업들과 반도체 패키징 및 테스트(OSAT) 업체들이 기업이 참여 의지를 나타낸 것으로 알려졌다.
하반기에는 산업통상자원부의 첨단 패키징 R&D 사업도 윤곽을 드러낼 것으로 보여 업계 기대감이 고조되고 있다. 5000억원 규모로 현재 예비타당성조사가 진행 중이다.
산업부 R&D는 단순 기술 개발에 그치지 않고 글로벌 기업과의 협업 및 수요 맞춤형 기술 개발 등 시장 공략을 전제로한 과제가 다수다. 패키징 업계는 이를 통해 기술 확보 동시에 사업화 성과도 기대하고 있다.

권동준 기자 djkwon@etnews.com








