인공지능(AI)을 향한 반도체 업계의 도전이 시작됐다. 설계부터 제조, 후공정까지 전 과정에서 AI 반도체를 업그레이드 하기 위한 기술 고도화가 진행됐다. 22일 서울 코엑스에서 개막한 '반도체대전(SEDEX 2025)'에서는 고성능 반도체 구현 솔루션들이 대거 공개돼 관람객들로 붐볐다.
◇ '반도체, 더 크게'
올해 반도체대전의 키워드는 단연 AI였다. 전 세계 반도체 시장을 뒤흔들고 있는 AI를 겨냥한 기술들이 눈길을 끌었다.
대표적으로 '빅다이(Big die)' 트렌드다. 고성능 구현을 위해 칩 크기가 커지면서 설계와 장비 기술들이 등장했다.
삼성 파운드리 디자인솔루션파트너(DSP)인 세미파이브는 최대 775제곱밀리미터(㎜²)에 달하는 칩 설계 기술을 선보였다. 범용 반도체 칩 크기가 수십 ㎜²인 점을 고려하면 이는 초대형 칩이다. 회사는 이미 10건 이상의 빅다이 프로젝트도 수행했다고 강조했다.
세미파이브 관계자는 “엣지 AI용 반도체는 181㎜², AI 데이터센터용은 400㎜²와 500㎜², 3차원(3D) AI 메모리는 775㎜²인 칩을 모두 수주했다”며 “제조 난도가 높은 빅다이를 맞춤형으로 설계할 수 있는 국내 유일 기업”이라고 강조했다.
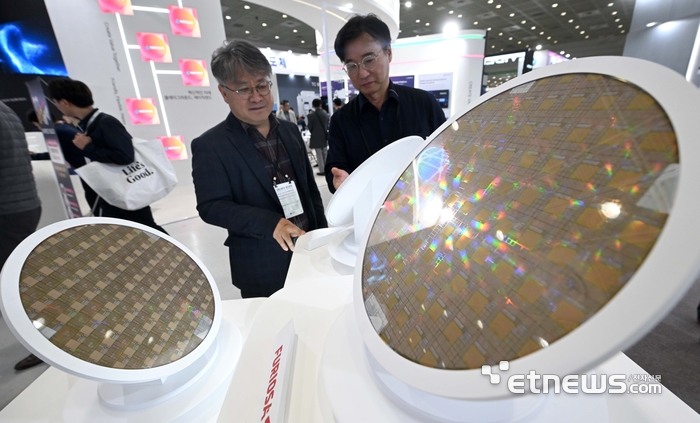
한미반도체는 빅다이에 대응할 수 있는 패키징 장비 '2.5D 빅다이 열압착(TC) 본더'와 '빅다이 FC 본더'를 국내 최초 공개했다. 각각 120×120㎜, 75×75㎜ 크기 대형 인터포저 패키징을 지원하는 장비로 AI 반도체에서 요구되는 초대형 칩과 멀티칩 집적을 지원한다.
회사는 6세대 고대역폭메모리(HBM4)용 '열압착(TC) 본더 4'도 선보여 눈길을 끌었다. 한미반도체 TC 본더는 HBM 제조에 필수 장비로 떠올라 SK하이닉스 외 마이크론 등에서 사용하고 있다.
국내 유일의 TSMC 파트너인 에이직랜드는 '칩 온 웨이퍼 온 서브스트레이트(CoWoS)' 기반의 칩렛 플랫폼을 전면에 내걸었다. CoWoS는 AI 반도체용 빅다이 칩을 설계하는 엔비디아가 사용하는 첨단 패키징 솔루션이다.
큐알티는 AI 반도체 신뢰성 검사를 위한 번인(Burn-in) 테스트 서비스를 소개했다. 샘플 칩을 기반으로 온도 변화에도 목표한 성능을 낼 수 있는지 점검해 반도체 신뢰성을 높일 수 있도록 지원하는 방식이다.

◇ 신사업 확장 나선 기업들
반도체 산업이 급성장하면서 사업영역을 넓히려는 기업들의 움직임도 전시회에서 엿보였다.
켐트로닉스는 제이쓰리를 인수해 실리콘 웨이퍼 재생에 이어 글라스 캐리어 웨이퍼 재생으로 사업을 확장 중이다. 본딩·디본딩 과정에서 미세 결함이 생긴 캐리어 웨이퍼 표면을 켐트로닉스의 유리 가공 기술을 활용해 복원하는 방식이다. 회사 관계자는 “글라스 캐리어 웨이퍼 재생을 위한 파일럿 라인을 구축했고 고객과 평가를 진행하는 중”이라며 “국내를 시작으로 해외 시장을 공략할 것”이라고 말했다.

동진쎄미켐은 전공정 소재 포토레지스트(PR)뿐만 아니라 첨단 패키징 소재도 소개했다. 범프 PR을 양산 공급한 데 이어 기판 내 전류가 흐르는 회로 간 간섭을 막는 동진빌드업필름(DJBF) 제품군을 넓히고 있다고 설명했다. 일본 아지노모토가 독점 중인데 동진쎄미켐은 핵심 성능 지표인 열팽창계수(CTE)와 유전손실계수(Df)가 낮은 특화 제품도 갖췄다고 강조했다. 이외에도 칩을 평탄화하는 화학기계적연마(CMP) 공정에서 사용되는 슬러리, 노광공정 이후 남은 잔류 범프PR을 제거하는 스트리퍼 등의 개발 현황을 공개했다.
이 외 케이씨텍은 CMP 장비와 슬러리를, 원익IPS는 화학기상증착(CVD)·원자층증착(ALD) 장비를, 피에스케이그룹은 PR 스트리퍼, 디스컴·리플로우 장비를 내세웠다.
김정회 한국반도체산업협회 부회장은 “AI 시대가 반도체 기업에 요구하는 것은 어제의 정답을 반복하는 것이 아니라 아무도 가보지 않은 새로운 길을 여는 혁신”이라며 “SEDEX에 소개된 기술들은 끊임없이 한계에 도전하는 우리 반도체 기업들의 결과물”이라고 말했다.
박진형 기자 jin@etnews.com, 이호길 기자 eagles@etnews.com










