
반도체 유리기판 미세 균열(마이크로 크랙)이 상용화 최대 걸림돌로 떠올랐다. 마이크로미터(㎛) 단위보다 작은 미세 균열을 사전에 찾아내지 못하면 유리기판 깨짐·찢어짐 현상이 발생하기 때문이다. 미세 균열 검사 공정이 제대로 이뤄지지 않으면 신뢰성을 갖춘 유리기판 양산이 어렵다는 지적이 나왔다.
시장조사업체 테크서치인터내셔널은 최근 발간한 '유리 코어 기판 발전과 과제' 보고서에서 인텔·BOE·이비덴·유니마이크론·다이니폰프린팅(DNP)·앱솔릭스(SKC 자회사)·삼성전기·LG이노텍 등 반도체 유리기판 사업을 준비하는 기업 기술 현황과 문제점을 분석했다.
테크서치인터내셔널은 “많은 기업이 유리 패널로 된 글라스관통전극(TGV)을 제조하고 있어 많은 진전이 있지만 아직 목표에는 도달하지 못했다”며 특히 “미세 균열을 감지하지 못하는 것이 심각한 문제”라고 지적했다.
반도체 유리기판은 기존 플라스틱 소재를 유리로 대체, 매끈한 평면과 휨 현상을 최소화하는 것이 핵심이다. 미세 회로를 구현하기도 용이하다. 인공지능(AI) 반도체 업계에서 유리를 차세대 기판 소재로 주목하는 이유다.
다만 유리로 제조되는 만큼 미세 균열 제어가 필수다. 마이크로미터 크기 혹은 그보다 작은 나노미터(㎚) 단위 미세 균열이 반도체 유리기판 제조 과정에서 기판 깨짐·적층 찢어짐(세와레) 등을 야기할 수 있어서다. 그러나 워낙 크기가 작고 유리가 빛을 굴절·반사하는 성질 때문에 미세 균열을 찾아내는 게 쉽지 않다.
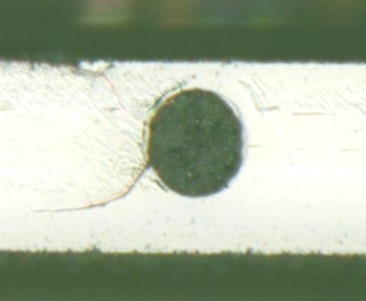
유리기판 내부에 전기적 신호를 내보내는 통로(TGV)까지는 다수 제조사가 구현에 성공했지만, 아직 완벽한 미세 균열 검사 체계가 구축되지 않았다는 것이 업계 중론이다. 한 유리 가공 장비 기업 대표는 “TGV 구현에만 집중하다 보니 미세 균열 심각성에 대한 인식이 부족했다”며 “이제야 글로벌 기업 중심으로 미세 균열을 사전에 파악하기 위한 작업에 착수했다”고 밝혔다.
일부는 유리기판 TGV 공정 이후 도금, ABF 등 필름 적층 과정에서 미세 균열이 초래한 깨짐과 찢어짐 현상이 발생하는 것으로 알려졌다. 또 최종 기판을 자르는 절단(싱귤레이션) 작업 후 미세 균열이 커지면서 기판 신뢰도를 떨어트리는 것으로 파악된다.
향후 미세 균열에 대한 사전 검사 및 제어가 어려울 경우, 반도체 유리기판 상용화 시점이 늦어질 수 있다고 우려하고 있다. AI 반도체 칩 패키지 가격이 워낙 비싼 만큼, 작은 결함도 전체 시스템에는 치명적인 문제로 작용할 수 있기 때문이다. 검사를 위한 신규 장비 뿐 아니라 미세 균열을 제어할 공정 방법론도 요구되는 상황이다.
테크서치인터내셔널은 “적층 수가 많은 유리기판 신뢰성 데이터가 제대로 공유되지 않고 있다”며 “(미세 균열에 대한) 보다 많은 데이터와 문제 분석이 필요한 상황”이라고 덧붙였다.
권동준 기자 djkwon@etnews.com









