네패스의 반도체 패키징 자회사 네패스라웨가 차세대 패키징 공정인 '팬아웃-패널레벨패키지(FO-PLP)' 생산 능력을 두 배 확대한다. 글로벌 반도체 고객사 수요 증가에 대응, 양산 능력을 끌어올리려는 전략이다.

네패스라웨는 7일 문승욱 산업통상자원부 장관, 이시종 충북도지사, 고객사와 협력사 대표 등이 참석한 가운데 청안캠퍼스 FO-PLP 라인 준공식을 개최했다. 회사는 지난 3분기 글로벌 반도체 기업의 전력관리반도체(PMIC) 인증을 마치고 본격 양산에 돌입했다. FO-PLP를 적용한 PMIC 양산은 네패스라웨가 세계 최초다.
네패스라웨는 내년 FO-PLP 생산능력을 두 배 확대한다. 고객의 PMIC 수요 증가에 따라 생산 인프라를 확충한다. 앞서 네패스는 내년 9월까지 FO-PLP 증설을 위해 1200억원을 투자할 것이라고 공시했다.

준공식을 진행한 팹은 축구장 25개 크기 18만6000㎡(5만6000평) 청안캠퍼스 대지 위에 첫 번째로 건설한 팹이다. 가로세로 600㎜ FO-PLP 기준 연간 최대 9만6000장을 생산할 수 있다. 정칠희 네패스 반도체 총괄 회장은 “FO-PLP 생산 시스템의 세계 표준을 제시한 네패스라웨가 한국의 새로운 후공정 생태계를 구축하는데 디딤돌 역할을 할 것”이라고 밝혔다.
네패스는 차세대 패키징 라인으로 스마트폰·자동차·사물인터넷(IoT) 등 응용처별 첨단 시스템 반도체 고밀도 패키징 솔루션을 제공한다. 정 회장은 “FO-PLP는 소재·부품·장비 등 국내외 파트너와 오랫동안 협력해 온 결과로 고사양 반도체를 위한 최적의 패키징 솔루션”이라며 “네패스는 앞으로도 파트너와 긴밀한 협력으로 첨단 기술 패키징 솔루션을 제공할 것”이라고 밝혔다.
문 장관은 네패스라웨 신공장 준공을 축하하며 첨단 패키징 기술 중요성을 강조했다. 문 장관은 패키징 산업 성과를 뒷받침하기 위해 “올해 첨단 패키징 플랫폼 대규모 예비타당성 사업을 추진하겠다”면서 “패키징 전문 인력 양성 사업 예산을 내년에 50% 증액할 계획”이라고 밝혔다. 산업부는 산·학·연 의견을 수렴, 패키징 산업 저변 확대를 위한 종합 대책을 내년 상반기 마련한다.
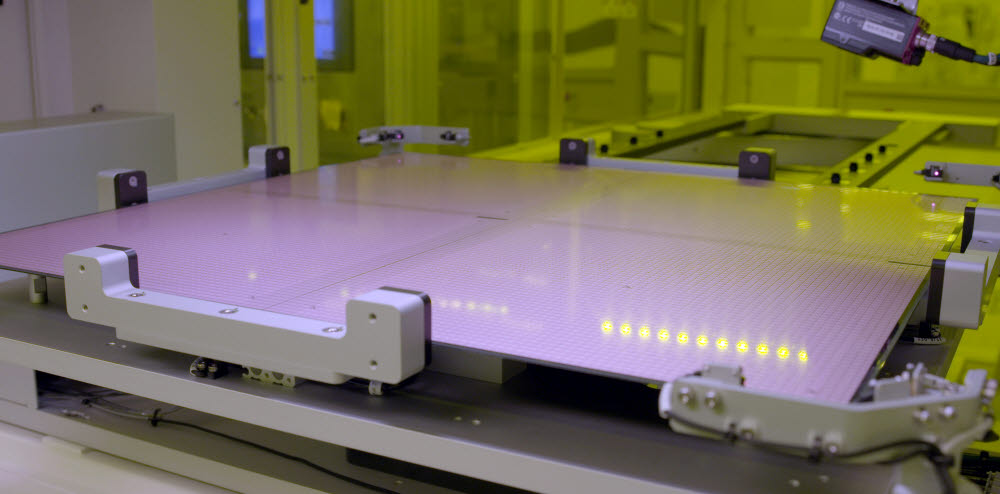
<용어설명>
◇팬아웃-패널레벨패키지(FO-PLP)=차세대 패키징 기술 중 하나. 반도체 입·출력 단자(I/O)를 칩 바깥으로 배치, I/O 수를 늘릴 수 있는 팬아웃(FO) 기술과 사각형 패널 위에 칩과 기기를 직접 연결, 패키징하는 패널레벨패키징(PLP)을 결합한 방식. 사각형이라 원형 대비 버리는 테두리를 최소화하고 칩을 더 많이 생산할 수 있다. 네패스의 600㎜ 정사각 패널은 12인치 웨이퍼 한 장 대비 다섯 배 많은 칩(다이)을 만들 수 있다.
권동준기자 djkwon@etnews.com









