
대덕전자가 비메모리 반도체용 패키지 기판 사업 확대에 본격 시동을 걸었다. 시스템반도체에 사용되는 플립칩볼그리드어레이(FC-BGA) 양산에 나섰다.
5일 업계에 따르면 대덕전자는 복수 고객사로부터 주문을 받아 최근 FC-BGA 생산을 시작했다.
회사는 솔리드스테이트드라이브(SSD)에 사용되는 컨트롤러용 FC-BGA와 스마트 TV 등 디스플레이 기기에 탑재되는 인공지능(AI) 반도체용 FC-BGA를 수주하고 지난 10월부터 생산에 들어갔다.
FC-BGA는 반도체칩과 기판을 볼 형태의 범프로 연결한 패키지 기판이다. 범프 연결을 플립칩(Flip-Chip)이라고 부른다. BGA는 칩보다 기판 사이즈가 더 큰 제품을 뜻한다. 칩보다 기판이 큰 것이 BGA, 칩과 기판 크기가 유사한 게 칩스케일패키지(CSP)다. CSP는 주로 스마트폰에, BGA는 PC 및 서버, 자율주행차, 데이터센터, AI 반도체 등에 쓰인다.
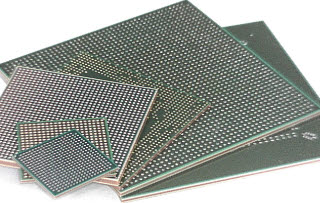
FC-BGA는 제조 난도가 높은 패키지 기판으로 꼽힌다. 일본 이비덴과 신코덴카, 국내 삼성전기를 포함해 세계적으로 10여개 업체만 대응할 수 있는 것으로 알려졌다.
대덕전자는 고부가 사업으로의 전환을 위해 FC-BGA를 준비해왔다. 시화 공장에 설비를 갖췄고, 지난 7월에는 900억원을 투자해 FC-BGA 설비를 신설하기로 결정했다. 이번 FC-BGA 양산은 신규 사업 육성 및 재편에 있어 의미 있는 첫 발을 내딛은 것으로 풀이된다.
대덕전자 관계자는 “다수의 글로벌 거래선으로부터 FC-BGA 개발 의뢰를 받고 있다”며 “AI를 활용한 디스플레이 제품과 대용량 SSD 등에 FC-BGA가 우선 적용될 것”이라고 전했다.
대덕전자는 2022년 FC-BGA 사업으로 연간 1500억~2000억원대의 매출을 거둔다는 목표다. 이를 통해 패키지 기판 사업 규모를 9000억원 수준으로 끌어올릴 방침이다. 현재 FC-BGA 사업은 생산 설비를 100% 가동했을 때 연간 500억원의 매출을 거둘 수 있는 것으로 전해졌다.
대덕전자는 지난 2분기 철수한 고밀도회로기판(HDI) 생산 공장을 활용해 FC-BGA 신공장을 준비하고 있다. 기존 HDI용 공정 설비(MSAP) 등을 활용하는 방식으로 공장 구성에 박차를 가하고 있다. 대덕전자는 내년 하반기부터 FC-BGA 전용 공장을 본격 가동할 계획이다.
윤건일기자 benyun@etnews.com









